Teljes útmutató a labdarács tömb (BGA) csomagolásához
A BGA (Ball Grid Array) csomagolás egy népszerű technológia, amelyet az integrált áramkörök, például a mikroprocesszorok tartós rögzítéséhez használnak a felületre.Jobb teljesítményt és magasabb PIN-sűrűséggel rendelkezik a hagyományos csomagolási módszerekhez képest, így a modern elektronika számára megoldást kínál.Ebben a cikkben megismerheti a BGA csomagolási folyamatát, annak előnyeit, kihívásait, különféle típusait és a BGA alkatrészeket.Katalógus
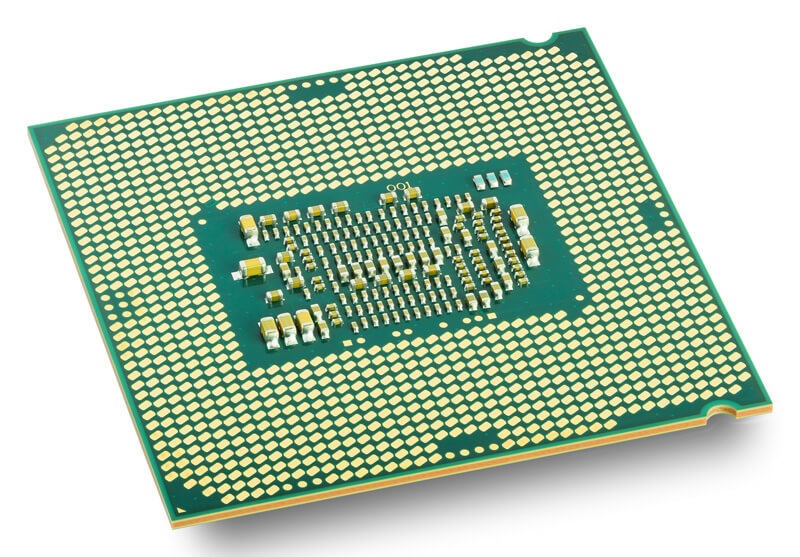
BGA áttekintés
A Ball Grid tömb (BGA) egy olyan csomagolási technológia, amelyet gyakran használnak az integrált áramkörök, például a mikroprocesszorok tartós rögzítéséhez a felülethez.Ezt a módszert általában használják, mert több csapot tesz lehetővé, mint más csomagok, például a kettős in-line csomag (DIP) vagy a Quad Flat csomag (QFP).Más csomagolási típusokkal ellentétben, ahol a csapok csak a szélek körül vannak elhelyezve, a BGA az eszköz alsó felületét használja a csapok elhelyezéséhez.Ez a beállítás segít csökkenteni a vezetékek teljes hosszát és javítja az eszköz sebességét, különösen a nagysebességű alkalmazásokban.
A BGA -csomagok forrasztásának folyamata pontos vezérlést igényel, amelyet általában automatizált berendezések felhasználásával végeznek gyári környezetben.Más típusú csomagoktól eltérően, a BGA eszközöket nem lehet csatlakoztatni aljzat segítségével, így a folyamat specializálódott.
A BGA technológia narratívája
A BGA Packaging egy frissítés a régebbi PIN Grid tömb (PGA) módszerből.A hagyományos PIN -elrendezés helyett a BGA a csomag alján forrasztógolyók rácsát használja.Ezeket a forrasztógolyókat manuálisan vagy automatizált gépekkel kell elhelyezni a fluxus segítségével.Amikor az eszközt a NYÁK -ra helyezik, a forrasztógolyók igazodnak a táblán lévő rézpárnákhoz.A következő lépés az eszköz melegítés vagy infravörös sütőben történő melegítése, ami a forrasztógolyók megolvadását okozza.Ahogy megolvadnak, a felületi feszültség segít a golyóknak a megfelelő helyzetbe mozogni, a készüléket a helyén tartva.Hűtés után a forrasztó szoros kapcsolatot alakít ki a csomag és a PCB között, biztonságosan rögzítve az alkatrészeket.
A BGA csomagolás előnyei
Nagy sűrűség
A BGA csomagolási technológiát fejlesztették ki az integrált áramkörök csomagolásának kihívásainak megoldására, amelyek sok csapot tartalmaznak.Régebbi csomagolási módszereknél, mint például a PIN-rács tömb (PGA) és a kettős in-line csomag (DIP), a csapokat a szélek köré helyezik, és a csapokat közelebb kell helyezni, amikor a csapok száma növekszik.Ez kihívásokat okoz a forrasztási folyamat során, mivel könnyebbé válik véletlenül összekapcsolni azokat a csapokat, amelyeket nem szabad összekapcsolni.A BGA technológia eltávolítja ezt a problémát az eszköz aljára elhelyezett forrasztógolyók használatával, ami lehetővé teszi a magasabb csap sűrűségét és a könnyebb kezelést az forrasztási folyamat során.
Javított hővezető képesség
A BGA csomagolás másik előnye, hogy javítja a hővezető képességet.A csapokat használó többi csomagolási típushoz képest a BGA alacsonyabb hőimpedanciával rendelkezik az eszköz és a PCB között.Ez azt jelenti, hogy az integrált áramkör által termelt hő könnyebben átvihető a PCB -be, segítve a chip túlmelegedését.A jobb hőeloszlás mellett javul az eszköz teljes teljesítménye és élettartama.
Alacsony induktív csapok
A BGA csomagolásban a készülék és a PCB közötti távolságot röviden tartják.Ez alacsony induktivitást eredményez, ami segít csökkenteni a nem kívánt jel torzulását, különösen a nagysebességű áramkörökben.A rövidebb vezetők azt jelentik, hogy a jelek kevésbé valószínű, hogy interferenciát tapasztalnak, javítva az eszköz általános teljesítményét.Ez az alacsony induktivitású szolgáltatás a BGA-t ideálissá teszi a nagysebességű elektronikus alkalmazásokhoz, jobb elektronikus jellemzőket kínálva más PIN-alapú eszközökhöz képest.
A BGA technológia hátrányai
Nem túlsúlyos kapcsolatok
A BGA csomagok egyik fő hátránya, hogy a forrasztógolyók nem rugalmasak, mint a hosszú csapok.Ez a rugalmasság hiánya azt jelenti, hogy a BGA -csomagok hiányoznak az anyagi merevség, ami problémákat okozhat a mechanikai feszültség vagy a termikus terjeszkedés alatt.A PCB és a BGA csomag közötti termikus tágulás különbsége hajlításhoz, nyújtáshoz vagy rezgéshez vezethet, ami végül a forrasztás ízületeit megtörheti.Ennek kezelése érdekében fontos, hogy illeszkedjen a PCB termikus tulajdonságainak a BGA csomaggal.A műanyag BGA -eszközök általában jobban megfelelnek ezeknek a tulajdonságoknak a kerámia BGA -eszközökhöz képest.
Problémák az ólommentes forrasztással
Egy másik kihívás merül fel az ROHS-kompatibilis, ólommentes forrasztó ötvözetek használatával.Ezek a forrasztók inkább hajlamosak olyan kérdésekre, mint a "fej-beolvasás" és a pad repedése az visszaverődés során, különösen olyan szélsőséges körülmények között, mint például a magas hőmérséklet, a termikus sokk vagy a magas G-erők.Az ólom-alapú forrasztásokhoz képest az ólommentes forrasztás alacsonyabb rugalmassága csökkentheti a BGA megbízhatóságát, különösen az igényes környezetben.
Mechanikai stresszoldatok
A mechanikai stressz kezelése érdekében az "alulfogyasztás" néven ismert technikát alkalmazzák.Ez magában foglalja az epoxi -keverék befecskendezését a BGA csomag alatt, miután azt a PCB -hez forrasztották.Ez elősegíti a BGA eszköz szoros rögzítését a PCB -hez, és csökkenti a stressz hatását.Különböző típusú alsó töltésű anyagok állnak rendelkezésre, lehetővé téve a testreszabást az egyes alkalmazások alapján.Az alulteljesítés egyik további előnye, hogy segít megelőzni az ón pofaszakállok növekedését, ami rövidzárlatot okozhat.
Ellenőrzési kihívások
Miután a BGA -csomagot a PCB -hez forrasztják, a hibák észlelése nehézkessé válik, különösen az alján, ahol a forrasztógolyók találhatók.Ennek leküzdése érdekében fejlett ellenőrző eszközöket, például röntgengépeket, tomográfiai gépeket, speciális mikroszkópokat és endoszkópokat használnak.Forrasztás meghibásodása esetén a csomagot infravörös lámpákkal vagy meleg levegő ventilátorokkal felszerelt "átdolgozó állomás" segítségével lehet eltávolítani, valamint egy hőelem és vákuumkészülékkel együtt.Ezt a folyamatot Reballing néven ismerték, ahol a sikertelen csomagot egy új váltja fel.
Fejlesztési szakasz nehézségek
A fejlesztési szakaszban a BGA -eszközöket közvetlenül a PCB -hez forrasztják.A folyamat megkönnyítése érdekében az aljzatot általában használják.Ezek az aljzatok azonban instabilok lehetnek.Kétféle aljzat létezik: a megbízhatóbb a forrasztógolyókra tartó rugócsapokat, de ez a módszer nem megfelelő, ha a forrasztógolyókat eltávolítják.A kevésbé megbízható opció a "ZIF nyerőgép" (nulla beillesztési erő), amely rugós bilincseket használ a forrasztógolyók helyén tartásához, de ezt a módszert nehéz használni, különösen akkor, ha a golyók kicsik.
Felszerelés költségei
A megfelelően forrasztott BGA -eszközök drága berendezéseket igényelnek.A kézi forrasztás nehéz és megbízhatatlan, tehát általában kis vagy barkácsprojektekhez tartozik.Mivel egyre több IC-t állítanak elő BGA-ban vagy ólommentes csomagokban, olyan DIY technikákban fejlődtek, amelyek olcsóbb fűtési forrásokat használnak, például forró levegőpisztolyokat, háztartási kemencéket vagy lapos fenekű elektromos tűzhelyeket, hogy kezeljék a BGA-eszközöket.Ezek a módszerek azonban kevésbé megbízhatóak, mint a professzionális forrasztókészülékek.
BGA csomag variánsok
Számos különféle típusú BGA -csomag létezik, amelyek mindegyike meghatározott igényekhez vagy alkalmazásokhoz készült.Íme néhány fő változat:
• CABGA: Chip tömb gömbrács tömb, egy olyan típusú BGA, amely chip -tömb elrendezést használ.
• CBGA és PBGA: Ezek az alap anyagára utalnak, amelyhez a BGA rögzítve van.A CBGA kerámia, míg a PBGA műanyagot használ alapanyagként.
• CTBGA: Vékony chip tömb gömbrács tömb, a chip tömb BGA vékonyabb változata.
• CVBGA: Nagyon vékony chip tömb gömbrács tömb, a chip-tömb BGA ultravékony változata.
• DSBGA: Die-méretű golyó rács tömb, egy méretű konfigurációval rendelkező BGA.
• FBGA: Finom gömbrács tömb, amely vékonyabb érintkezőket használ.Általában a rendszer-on-chip-tervekben használják.Az altera Fineline BGA -nak hívja.Ez különbözik a dúsított BGA -tól.
• FCMBGA: Flip chipek öntött golyósrács tömb, egy BGA, amely flip chip kötést használ.
• LBGA: Alacsony profilú golyó rács tömb, vékony BGA-kialakítás.
• LFBGA: Alacsony profilú, finomhangú gömbrácsos tömb, vékony és finom pitch BGA.
• MBGA: MICRO BALL Rács tömb, a BGA kisebb verziója.
• MCM-PBGA: Multi-chip modul Műanyag gömbrács tömb, egy műanyag BGA, amelyet több chip modulokhoz használnak.
• PBGA: Műanyag gömbrács tömb, műanyag alapú BGA.
• Superbga (SBGA): Super Ball Grid tömb, a BGA rendkívül fejlett verziója.
• TABGA: szalagos tömb BGA, egy BGA, amely szalaghordozót használ a tömbjéhez.
• TBGA: Vékony BGA, egy olyan verzió, amely vékonyabb, mint a szokásos BGA.
• TEPBGA: Hőileg továbbfejlesztett műanyag gömbrácsos tömb, egy műanyag BGA, továbbfejlesztett hőtulajdonságokkal.
• TFBGA: Vékony és finom gömbrács tömb, amely mind vékony, és finom hangmagassággal rendelkezik.
• UFBGA vagy UBGA: Ultra Fine Ball Grid tömb, a BGA nagyon finom változata.
Számos BGA -csomagnak van forrasztógolyója a csomag széle körül, a belső négyzet területe üres maradt.
Az Intel néhány ilyen BGA csomagolási módszert alkalmazott, például a BGA1 -et a korai Pentium II és a Celeron mobil processzorokhoz.Később az Intel bevezette a BGA2-t (más néven FCBGA-479), hogy helyettesítse a BGA1-et a Pentium III és néhány későbbi Celeron processzorra.
A BGA technológiájának egyik példája a Micro-FCBGA, amelyet az Intel használ a mobil processzorok számára, például a Celeron "Coppermine".Ez a módszer 479 forrasztógolyót használ, amelynek átmérője 0,78 mm, és a processzort az alaplapra forrasztják.A Micro-FCBGA-nak 26x26 négyzet alakú rácsja van, hat perifériás 1,27 mm-es pályával.A belső terület (14x14) üres marad.
Információ vásárlása a BGA csomagokhoz
A BGA csomagokat elsősorban az eredeti berendezésgyártók (OEM) vásárolják, akik ezeket az alkatrészeket használják termékeikben.Az OEM -ek általában közvetlenül a gyártóktól vagy a nagykereskedőkön keresztül fordítják alkatrészeiket.Másrészt a barkácsolás rajongói és a hobbisták, akik élvezik az elektronikával való együttműködést, szintén megtalálhatják a BGA alkatrészeket a piacon.Általában ezeket az alkatrészeket elektronikus alkatrész -beszállítóktól vagy nagykereskedőktől vásárolják, amelyek a módosított vagy többlet termékekre szakosodtak.Ez a BGA csomagokat egyre népszerűbbé tette azok körében, akik szeretik saját eszközeiket felépíteni vagy javítani.
Rólunk
ALLELCO LIMITED
Olvass tovább
Gyors lekérdezés
Kérjük, küldjön egy kérdést, azonnal válaszolunk.

A mikroprocesszoros egységek és a memóriavédelmi rendszerek megértése
2025/01/5 -en

Miért a MATLAB a legjobb választás az összetett számításokhoz?
2025/01/5 -en
Népszerű hozzászólások
-

Komplex utasítás beállított számítógépek: Hogyan változtatták meg a számítástechnikát?
8000/04/18 -en 147749
-

USB-C pinout és funkciók
2000/04/18 -en 111904
-

A Xilinx Unified Simulation Primitívumok használata: Átfogó útmutató az FPGA tervezéséhez és szimulációjához
1600/04/18 -en 111349
-

Tápfeszültségek az elektronikában: VCC, VDD, VEE, VSS és GND jelentése
0400/04/18 -en 83714
-

RJ45 Csatlakozó útmutató: Pinout, vezetékek, kábeltípusok és felhasználások
1970/01/1 -en 79502
-

A végső útmutató a vezetékes színkódokhoz a modern elektromos rendszerekben
Az, ahogyan az elektromos rendszereink a színeket használják, nem csak a megjelenéshez.Minden huzalszín most egy adott funkciót jelöl, megkönnyítve az elektromos alkatrészek azonosítását és kezelés...1970/01/1 -en 66869
-

Minőség (q) tényező: egyenletek és alkalmazások
A minőségi tényező, vagy a „Q” fontos, amikor ellenőrzi, hogy az induktorok és a rezonátorok hogyan működnek az elektronikus rendszerekben, amelyek rádiófrekvenciákat (RF) használnak.A 'Q' megméri,...1970/01/1 -en 63004
-

Tisztító szelep útmutató: funkció, tünetek, tesztelés és a motor optimális teljesítményének cseréje
A tisztítószelep az autó rendszerének kulcsfontosságú része, amely segít a levegő tisztaságának megőrzésében az üzemanyag -gőzök kezelésével, mielőtt elmenekülhetnek a légkörbe.Ez nem csak a szenny...1970/01/1 -en 62942
-

A csúcsteljesítmény elérése a maximális energiaátviteli tételgel
A maximális teljesítményátviteli tétel elmagyarázza, hogy a forrásból, például az akkumulátorból vagy a generátorból származó energia hogyan áramlik a csatlakoztatott terhelésbe.Megmutatja azt a po...1970/01/1 -en 54076
-

A23 akkumulátor specifikációi és kompatibilitása
Az A23 akkumulátor egy kicsi, hengeres alakú akkumulátor, nagy feszültséggel.A 23A, 23AE vagy MN21 néven is 12 voltos és sokkal magasabb, mint az AA vagy AAA akkumulátorok.Különleges kiala...1970/01/1 -en 52087















































